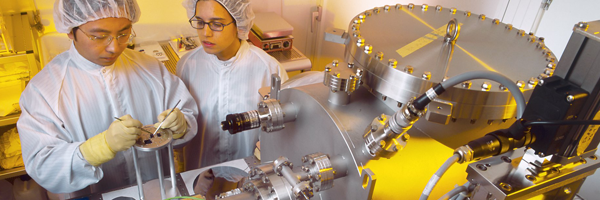
XIL-II (X09LB): Extreme Ultraviolet Interference Lithography
The X-ray Interference Lithography (XIL) beamline provides spatially coherent beam in the Extreme Ultraviolet (EUV) energy range. The light from the undulator source is filtered by a pinhole spatial filter to deliver spatially coherent illumination in the custom designed exposure chamber.
| Energy range | 70 - 500 eV |
|---|---|
| Flux (92 eV) | 3 x 1015 ph / s / cm2 / 4%BW / 0.3A |
| Spot size | 5 mm x 5 mm |
More Information
Visit the group website for more information.
News
2. July 2015:
XIL-II demonstrates seven nanometer resolution: PSI News on our publication:
Single-digit-resolution nanopatterning with extreme ultraviolet light for the 2.5 nm technology node and beyond,
N. Mojarad, M. Hojeij, L. Wang, J. Gobrecht, and Y. Ekinci
Nanoscale 7, 4031 (2015)
DOI: 10.1039/C4NR07420C